- 经过多年研发创新,邑文科技已掌握干法刻蚀、薄膜沉积、真空热处理等领域的多项核心技术,并广泛应用于半导体的前端工艺,特别是在化合物半导体、MEMS 以及逻辑、存储等先进制程领域

在半导体制造持续向更小制程、更大晶圆尺寸发展的今天,12英寸晶圆已成为高端芯片制造的主流。等离子体增强化学气相沉积(PECVD)作为薄膜沉积工艺中的关键环节,其工艺质量与设备稳定性直接影响了器件的性能与良率。
12英寸PECVD是推动摩尔定律延续的关键引擎之一,其重要性体现在:
1.晶体管性能提升的赋能者
在先进制程结构中,通过沉积精确的应力薄膜,直接调控晶体管沟道的应力状态,是提升驱动电流、降低功耗的核心技术之一。
2.先进互连技术的支撑点
随着芯片集成度提高,互连层数多达十几层。12英寸PECVD沉积的low-k / Ultra low-k介质膜是降低线间电容、防止信号串扰和延迟,提升芯片运算速度、降低功耗的关键。此外,其卓越的间隙填充能力确保了复杂互连结构的可靠绝缘。
3. 提升效能与降低成本的核心
单片12英寸晶圆所能产出的芯片数量是8英寸的2.5倍以上,大幅降低了单片芯片的制造成本。同时,其更高的自动化水平和生产效率,使得大规模、经济地生产先进芯片成为可能。
基于12英寸PECVD技术的上述关键作用,邑文科技紧跟产业升级趋势,正式推出自主研发的12英寸电容耦合等离子体增强化学气相沉积设备(SPV 12D),为先进半导体制造,提供高性能、高稳定性的国产化薄膜沉积解决方案。该设备目前已深入布局12英寸先进制程领域,是推进12英寸PECVD机型国产化的重要力量。
一、邑文科技12英寸PECVD产品概述
产品介绍
SERIC Plasma SPV 12D 是邑文自主研发设计的一款高性能12英寸等离子体增强化学气相沉积(PECVD)薄膜设备,旨在为半导体集成电路制造企业解决先进制程中薄膜沉积的均匀性、致密性和工艺稳定性等核心问题,助力客户实现高性能、高可靠性的集成电路生产。
超凡的薄膜均匀性:搭载自主研制的高精度等离子体源与反应腔室智能气流控制系统,可在整个12英寸晶圆上实现优于<1.5%的薄膜厚度均匀性与匹配的应力。这意味着更高的良率、更一致的器件性能。
广泛的材料体系:全面支持多种关键介质薄膜的沉积,包括:
SiO₂(氧化硅):作为标准的隔离层和保护层。
SiN(氮化硅):优异的刻蚀停止层和钝化层。
SiON(氮氧化硅):用于抗反射涂层和栅极介质。
低k介质材料:助力降低RC延迟,提升芯片速度。
超高吞吐率:优化的多腔室集群架构与高速机械手传输系统,将单wafer处理周期降至最低,产能显著提升,降低单芯片制造成本。
卓越的颗粒控制与 uptime:采用邑文专利的腔室清洁技术与颗粒控制方案,将晶圆颗粒污染控制在<10颗(@>0.06μm)的极低水平。模块化设计与先进的故障预测诊断系统,确保了设备超过90%的持续稳定运行时间,提高产线运转效率。
智能化与自动化:全面兼容工厂自动化系统,支持SECS/GEM通讯协议,实现全自动化晶圆生产与数据追踪,确保每一片晶圆都处于最佳工艺窗口。
成熟稳定的平台设计:基于经过市场验证的成熟平台,关键部件寿命长,维护周期间隔久,大幅降低备件消耗与维护成本。
绿色节能:优化的气体输送系统与高效的真空泵组,显著降低了工艺气体和电力消耗,助力实现可持续的绿色制造。
产品应用
SPV 12D PECVD设备可广泛应用于集成电路逻辑芯片(FinFET、GAA)、存储芯片(3D NAND, DRAM)、图像传感器(CIS)、微机电系统(MEMS)、功率半导体与先进封装等领域,可沉积 SiO2、SiN、TEOS、SiON、SiOC、FSG、 BPSG、PSG 等通用介质薄膜材料,以及Low k等先进介质薄膜材料,为各类半导体产品提供关键的薄膜工艺支持。
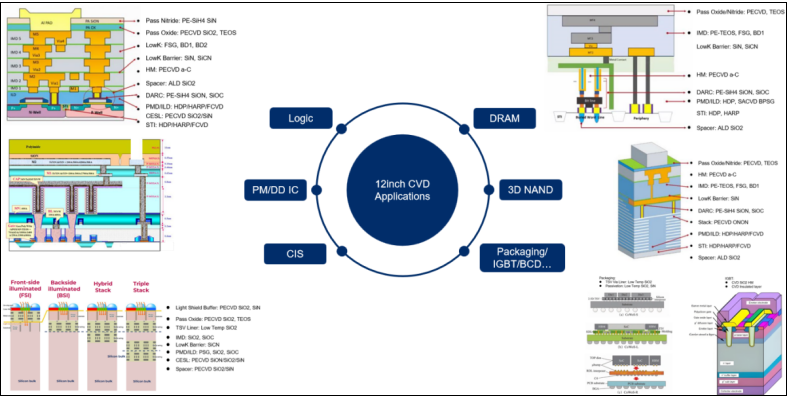
二、设备工艺概述
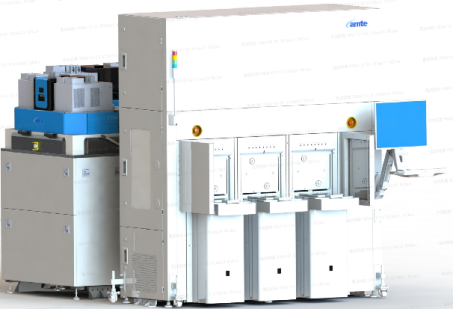
机台型号:SERIC Plasma SPV 12D
制造商:AMTE
适用材料:SiO2、SiN、SiON、SiOC、FSG、 BPSG、PSG 等通用介质薄膜材料,以及LoK-Ⅰ、 LoK-Ⅱ等先进介质薄膜材料。
适用领域:集成电路逻辑芯片(FinFET、GAA)、存储芯片(3D NAND, DRAM)、图像传感器(CIS)、微机电系统(MEMS)、功率半导体与先进封装等领域。
三、工艺流程概述
样品信息与需求
1、样品信息
样品名称:12 inch bare-Si
2、薄膜目标要求
薄膜类型:SiN-UV6K
均匀性:<3%
低H含量(Atoms%):客户样品Si-H(3.49%)、N-H(13.48%)、Total(16.97%)
PECVD工艺参数设计
RF Power(HF/LF):200~2000W/50~200W,影响Plasma密度和能量
Pressure:2~4Torr,影响Plasma密度、均匀性
Gas Ratio:SiH4:NH3:N2O₂~1:0.8:45,影响致密性、化学原子比
Spacing:18~22mm,影响均匀性和沉积速率
Temperature:390~410°C,影响沉积速率、致密性、均匀性
薄膜沉积步骤
腔室Go Clean
利用远程等离子体清洁装置对腔体进行清洁,随后在腔体内沉积一层薄膜,以提供稳定工艺的初始环境。
晶圆传输
通过全自动机械手进行晶圆传输。
薄膜沉积
Step1:预热。
Step2:稳定工艺气体流量和腔体压力。
Step3:进行主沉积步骤。
Step4:吹扫剩余气体和副产物,抽空腔体。
均匀性分析
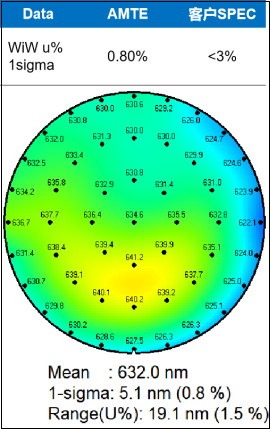
XPS H含量分析
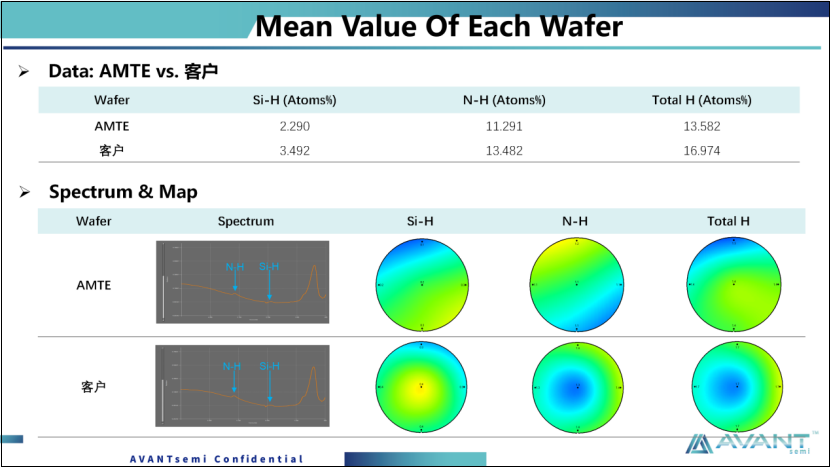
四、工艺结果与结论
本次工艺案例旨在满足高均一性,低H含量的SiN薄膜沉积需求,相关表征测试结果如下:
工艺效果评估
基于当前设定的射频功率、气体配比、腔室压力、Gap值等工艺参数,所沉积SiN薄膜达到预期效果,具体包括:
均一性:椭偏仪测试结果表明,制备的SiN薄膜均一性为0.8%,满足客户技术要求(<3%)。
薄膜H含量:XPS表征结果显示,制备的SiN薄膜Si-H/N-H/Total H含量分别为2.29%、11.291%、13.582%,均优于客户提供的标准样品的3.49%、13.482%、16.974%。
结论
以上结果表明AMTE SPV 12D 12英寸PECVD设备,在高均一性、高质量薄膜沉积工艺上展现出优异性能,为先进制程半导体制造对器件性能一致性与稳定性的高要求提供了可靠保障。
总结
SERIC Plasma SPV 12D设备已在12英寸半导体制造产线上达到工艺要求。通过技术创新、市场验证和政策支持,突破半导体设备关键核心技术,推动国产化替代,逐步缩小与国际领先水平的差距,为半导体产业国产化贡献力量。未来,随着技术的不断突破和市场需求的增长,AMTE设备将迎来更广阔的发展空间。(此文出自见道官网www.seetao.com未经允许不得转载否则必究,转载请注明见道网+原文链接)见道网企业宣传栏目编辑/程丽婷
评论
 赞
赞
 收藏
收藏
 评论
评论
 搜索
搜索














写点什么吧~